초미세공정이 되면서 멀티 패터닝 공정으로도 더이상 효율이 나오지 않음 => 새로운 광원의 활용!!!
-EUV: 13.5nm
1. 장점: Scaling Down의 끝판왕- 단파장의 고에너지 광원. 초미세 공정이 가능 (10nm미만 공정 가능).
기존 공정보다 적은 횟수의 공정 단계로 패터닝이 가능- QPT 대체 기술. Mask 제작 비용 감소
2. 단점: 빛 흡수 이슈 해결 필요(주위 설비, Mask, Lens, 산소와 이산화탄소 등에 흡수) ->진공 상태,
빛의 효율이 낮아 생산성 낮음, 양산 어려움. 공정 난이도가 매우 높고, 비싸고, 느림.
3. 특징: EUV Mask는 일반 Mask와 달리 반사형 렌즈와 거울 이용. 반사율을 위한 다층 구성. (반사각 중요!),
4. 광원 형성
플라즈마를 발생시켜 광원을 만듦. – 이때 발생하는 Sputtering된 입자가 Mask를 손상시키지 않도록 해야함.
+DPP (Discharge Produced Plasma): 대 전류 펄스를 흘려 Plasma 발생.
+LPP (Laser Produced Plasma): 높은 에너지의 CO2 Laser가 특정 물질(주석, Sn)과 반응해 Plasma 발생

5. PR-PR Issue-패턴이 10nm면 PR의 두께는 20nm가 한계…
고해상도, 고감도(=적은 양의 에너지로 반응함, 커지면 시간이 증가함) PR 필요-변수가 많아 어려움
화학증폭형 PR 효율이 낮음. DUV의 경우 Acid 가 Exposure 즉시 발생했다면,
EUV는 Resin의 2차 전자 생성이라는 전 단계가 있어 효율이 낮음. 즉, 반응성이 낮음.
얇아지면서 Etch resistance 문제도 중요해짐.
또한, 고에너지의 EUV 광원은 PR을 반응시켜 Gas를 발생시킬 수 있음.
PR 고찰: RLS Trade Off 관계인 Resolution과 Sensitivity(단위: mJ/cm2), LWR의 최적화
(모두 작아야 좋아짐)
++LWR (Low Width Roughness) (=LER (Low Edge Roughness)) : 패턴 라인의 거칠기 값,
Photon의 수가 적을수록(감도가 낮아질수록(=좋아질수록) 커짐) (울퉁불퉁 해짐=PR Profile이 안 좋아짐).
->추가설명: KrF와 EUV를 같은 양의 빛을 준다고 할 때, 상대적으로 작은 에너지인 KrF는 대부분의 빛을 사용하지만, 큰 에너지인 EUV는 적은 양의 빛으로도 쉽게 Resist Threshold Energy에 도달해 LWR이 커짐.
즉, 적은 에너지로 패터닝 가능하다는 것을 의미하며 이는 민감도가 낮아질수록 LWR도 낮아진다고 할 수 있음.

++ Sensitivity가 작아야 좋은 이유 (가장 중요함)
PR A의 Sensitivity가 10mJ/cm2이고, PR B의 Sensitivity가 30mJ/cm2일 때 외부에서 가해지는 에너지가 초당 5mJ/cm2로 주어진다면 반응하기까지 PR A는 2초, PR B는 6초가 걸림. 따라서 시간 및 에너지와 관련해 Sensitivity는 작을수록 좋음.
=> 최신 트렌드: 유기물 PR이 아닌 무기물 PR은 어떨까?
공통점: 유기물이 없는 것이 아니라 무기물을 유기물이 둘러싸고 있는 형태인데, 무기물은 EUV(광원, 빛)와 반응하면서 주변 유기물을 날리고, 자기들끼리 엉키면서 굳음. (Negative Type), 금속이니까 Etch Resistance도 좋음.
1. 무기나노클러스터 Resist- 인프리아: 액체상태(코팅력 우수)
2. Dry Resist- 램리서치: 액체로 진행하는 것이 아니기 때문에 Gas 처리비용, Solvent 문제, 표면장력 문제 해결 가능.
기존처럼 하는 것이 아니라 CVD를 이용해서 하는 방법

6. 왜 EUV를 써야 하는가?
-QPT, FinFET, GAA 공정 등 미세화를 위해 다양한 기술이 사용되면서 공정단계가 늘어나고, 시간이 길어지면서 단가가 증가해 원가절감을 위해 미세화를 하는 이유가 없어졌기 때문입니다. 이를 위해 다시 가격경쟁률을 갖추기 위해선 EUV가 필요합니다.
7. 마스크(Mask) 재료: Blank Mask(Ru(루테늄) Base Capping layer, Ta(탄탈륨) absorption layer(=Protection Layer)), EUV에서는 반사형 사용

EUV에서 반사형을 사용하는 이유
투과형의 경우 흡수율이 높음. 작은 흡수율의 Cr(크롬)은 제대로 패턴을 형성하지 못함. 이를 해결하기 위해 반사형 MultiLayer 구조로 Mask 형성
++Si/MO MultiLayer Bragg 반사경(=EUV Mask) (약 40~50층, 250~350nm, 층당 6~7nm) 약 6인치
Fresnel Equation에 따라 반사율을 올려주기 위해 만들어진 구조.
주기가 많다고 꼭 확률이 올라가는 것은 아님
(Bragg`s Law에 따라 보강간섭이 되어 상쇄 없이 반사되도록 하는 것이 중요!)
+Fresnel Equation (프레넬 반사법칙):
경계면에 특정 각도로 빛이 입사되면 투과율과 반사율이 결정이 된다는 법칙.
+EUV Mask 3D Effect: EUV는 약 6도 기울여서 입사되는데 이때 3D 구조이기 때문에 Shadowing Effect와 이미징 수차가 발생
-최소화를 위한 방법
1. 더 얇은 탄탈(Ta) 계열 흡수체 개발 – 5nm이하 공정에서 어려울 것으로 예상. 현재 55nm 두께가 한계
2. 새로운 흡수체 - 5nm이하 공정을 위한 새로운 흡수체가 필요함. Co/Ni(Etching 어려움) 등 연구 중
3. 새로운 Mask 재료 – 높은 반사율을 위한 재료 필요, Ru/Si 등…
4. High-NA EUV 기술 적용 – 커질수록 미세한 패턴 가능, 즉 반사경을 크게 만드는 것.
배치가 상당히 복잡해 Performance문제 해결이 필요(무작정 키울 수는 없음). 이는 간섭된 영역을 만듦
5. 광 입사각을 6에서 9로? – Mask 3D Effect 심화
6. 배율 축소를 1/4에서 1/8로? – Throughput 감소
7. 마스크 크기를 6인치에서 12인치로? – 마스크 생태계를 갈아 엎어야 함
=>아나모픽(Anamorphic) 기술로 해결!
원 모양의 빛을 가로모양으로 길게 나눈 타원형의 빛을 사용하는 방법.
빛의 양은 줄어들지만 간섭되는 부분을 없애면서 Mask 3D Effect를 감소.
이는 회로를 형성하기 위해 2번의 Exposure이 필요해 Throughput 이 감소. But. 배율 축소 보다 양호.
이를 해결하기 위해 ASML은 속도를 높이기 위해 노력 중.
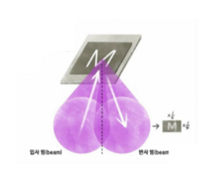

Reticle: 설계 도면(Pattern)을 포함한 Photo Mask -액정보호필름, 쿼츠 유리판, 크롬(Cr)코팅
Pellicle(펠리클): 빛 투과율이 높은 특수 소재로 만들어진 얇은 고분자 기능성 막(소모성), 오염 입자가 Mask에 떨어지는 것을 막아 줌. 생산성이 떨어지지만 수율이 올라가고 마스크 세척 주기가 줄고 수명이 늘어남. EUV에서 매우 중요함. 고가.
++펠리클이 EUV에서 중요한 이유
1) 빛이 두 번 투과되기 떄문에 투과율이 더 좋아야 함.
예를 들어 투과율이 90%의 펠리클은 EUV에서 두 번 통과하기 때문에
0.9×0.9=0.81, 81%의 투과율을 가짐.
현재 삼성전자 88%달성, 에스엔에스텍(협력사) 91% 달성, ASML 95%목표
2) 열적 특성이 우수해야 함. EUV 빛은 주변에 매우 잘 흡수되어 열에너지로 바뀌는데
이때, 펠리클의 온도가 600~1200도까지 가열 후 냉각되기 때문에 열적 특성이 우수해야 함.
낮은 열팽창 계수 필요. 4~6ppm/K 미만(*ppm(Percent Per million: 1×10-6)
3) 기계 및 화학 특성이 좋아야 함. 얇기 때문에 외부 충격에 쉽게 손상될 수 있음(빛이 고에너지이기 때문).
Mask 이동시 손상이 있을 수 있으므로 기계적 특성이 좋아야 함.

'반도체 > 노광 공정 (포토 공정, Photolithography)' 카테고리의 다른 글
| [포토 공정] 포토공정. 패턴 형성 첫번째 과정 - PEB , Development, Hard Bake, ADI (1) | 2024.08.29 |
|---|---|
| [포토 공정] 포토공정. 패턴 형성 첫번째 과정 - Alignment & Exposure (0) | 2024.08.29 |
| [포토 공정] 포토공정. 패턴 형성 첫번째 과정 - HMDS 도포, PR Coating, Soft Bake (0) | 2024.08.29 |